不同結(jié)構(gòu)的IGBT模塊的特點(diǎn)及工作原理
- 編輯 :
深圳逸盛通科技有限公司
時(shí)間 : 2018-09-17 20:37 瀏覽量 : 124
-
(1)p溝IGBT
在數(shù)字秒儀表控制電路中常常采用互補(bǔ)器件技術(shù)來提高電路的負(fù)載能力和抗干擾能力��,降低功耗����。譬如n溝MOS與p溝MOS并聯(lián)組成的CMOS結(jié)構(gòu)��。p溝IGBT即是為此目的而開發(fā)��。由于硅中空穴的遷移率只有電子遷移率的1/3左右����,相同尺寸p型溝道的通態(tài)電阻是n型溝道的3倍左右��,所以p溝功率MOS很少使用�。但是IGBT的情況有所不同���。由于集電結(jié)J1的注入作用����,p溝IGBT正向?qū)〞r(shí)由集電區(qū)注入到長基區(qū)的是遷移率高的電子�����,其電導(dǎo)調(diào)制效果比n溝IGBT強(qiáng)��,在柵壓足夠高的線性工作區(qū)狀態(tài)下���,這足以彌補(bǔ)溝道電阻的增高���。n溝IGBT的溝道電阻雖然相對(duì)較低,但其J1結(jié)向基區(qū)注入的是遷移率較低的空穴�。所以,在條件相同的情況下,p溝IGBT和n溝IGBT的通態(tài)壓降其實(shí)很接近����,使之更適合于互補(bǔ)結(jié)構(gòu)的應(yīng)用。
(2)高壓IGBT
跟功率MOS一樣�����,提高IGBT的阻斷電壓也需要提高其長基區(qū)的材料電阻率�����,并增加其寬度�����。但是�,由于j1結(jié)的高密度少子注入��,長基區(qū)的材料電阻率對(duì)通態(tài)壓降并無多大影響��。IGBT的通態(tài)壓降主要決定于長基區(qū)的寬度����。當(dāng)IGBT的阻斷電壓隨長基區(qū)的加寬和材料電阻率的增高而提高時(shí),與相同條件下的功率MOS相比�����,其通態(tài)壓降的增加要小得多。用阻斷電壓分別為300V�����、600V和1200V的對(duì)稱結(jié)構(gòu)IGBT器件所作的通態(tài)特性比較測(cè)試結(jié)果表明���,IGBT的通態(tài)電流密度近似地隨著擊穿電壓值的平方根的增加而減小����。電流密度以這種較為平緩的比率減小的特點(diǎn)���,表明了開發(fā)高壓大電流IGBT的可行性���。
(3)高溫IGBT
如前所述,IGBT的MOSFET部分和pin二極管部分互補(bǔ)的高溫特性使其很適于在高溫環(huán)境下使用�����,尤其是針對(duì)高溫應(yīng)用目的而充分利用了這種互補(bǔ)性而設(shè)計(jì)的高溫IGBT����。這種器件在額定電流下的通態(tài)壓降幾乎不隨溫度變化����,而在最高允許電流下具有一定大小的正溫度系數(shù)�,從而確保良好的均流效果,有利于組裝大電流模塊��。高溫IGBT通常都采用圖1所示的短基區(qū)局部短路的非對(duì)稱器件結(jié)構(gòu)�����,進(jìn)一步防止寄生晶閘管在高溫工作狀態(tài)下可能發(fā)生的自鎖效應(yīng)�。
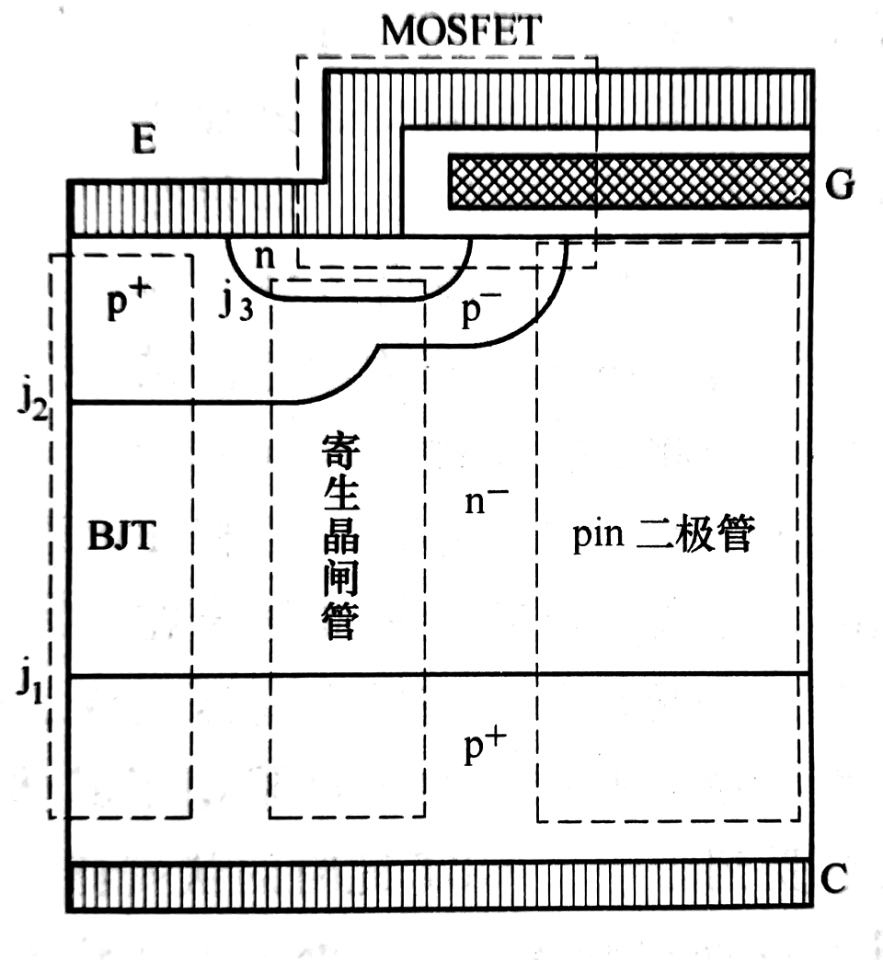
圖1 n溝道IGBT結(jié)構(gòu)示意圖
(4)槽柵IGBT
槽柵IGBT的柵極結(jié)構(gòu)與圖2所示的UMOS相同,可將其看成是將UMOS的n+襯底換成p+襯底的結(jié)果�,因而又叫UMOS-IGBT�。與UMOS類似,其U形槽必須挖到j(luò)2結(jié)之下��,以使n+發(fā)射極與n基區(qū)之間能夠用柵壓感應(yīng)的n型溝道連通����。如此一來,槽柵IGBT中就消除了DMOS和平面柵IGBT中都存在的累積層電阻Ra和寄生JFET電阻Rj��。此外,槽柵結(jié)構(gòu)可以縮小器件單元的中心距���,使溝道密度增加�����。因此槽柵IGBT的通態(tài)特性有很大改善����,在n基區(qū)額外載流子壽命較高的場(chǎng)合�����,其通態(tài)壓降相對(duì)于平面柵IGBT能降低大約1/3�����;在為了提高開關(guān)速度而降低額外載流子壽命的情況下��,這兩種結(jié)構(gòu)的通態(tài)壓降會(huì)相差更大�。槽柵IGBT的抗自鎖能力也比平面柵IGBT高。這歸因于槽柵結(jié)構(gòu)中空穴電流路徑的改變���。
圖2 槽柵IGBT的柵極結(jié)構(gòu)




 英飛凌igbt銷售
英飛凌igbt銷售